PI光刻显影工艺实验研究

王丹丹 安静 宁磊 王雅惠 李娜 邓佩荣
西安卫光科技有限公司 陕西 西安 710000
引言
Polyimide(聚酰亚胺树脂简称PI)是指主链上还有酰亚胺环的一类高分子聚合物,是目前能够实际应用的耐高温性能最强的一类高分子材料,具有良好的热稳定性、高强度、高韧性等优良特性[1]。Polyimide(聚酰亚胺树脂)作为绝缘和钝化层,具有良好的机械伸长率和拉伸强度,加上耐腐蚀性和高温稳定性,其在受到各类环境压力时可对整个器件提供可靠的保护[2]。广泛应用于航空航天、卫星通信、电气绝缘、微电子工业、国防军工、精密电子机械等高精尖领域[3]。超高压产品通过使用聚酰亚胺PI 工艺可以提高器件的可靠性[4]:如防止化学腐蚀、减少因热应力引起的电路崩裂断路等,从而提升半导体芯片整体的可靠性;当作为保护膜时,能够减少环境对器件的影响,还可以对α-粒子起屏蔽作用,减少或消除器件的软误差,提升半导体器件的稳定性和可靠性。
目前,晶圆PI 层,是指在半导体制造过程中使用的一种高分子材料层,PI 层通常作为介电层或薄膜封装材料使用。他的主要作用有以下几点[5]:1.作为介质隔离,减少电路间干扰,提高器件性能;2.作为保护层,防止底层电路受到环境中水汽等因素的侵蚀;3.作为光刻胶基底,用于精微加工过程中的图案转移。
由于Polyimide 不溶于一般溶剂。因此,在应用为光刻胶时,不能像其他光致抗蚀剂一样先将它溶于某一溶剂,再涂布成膜。普遍采用的方法是先涂布“Polyimide 前质” (PolyimidePrecursor),再经过退火转换成最终聚酰亚胺粘合剂(Final Polyimide Bond)[6]。所以,我们平常所说的 Polyimide 胶其实并不是 Polyimide 而是它的反应前质。
本实验研究主要是将PI 作为光刻胶基底,在晶圆表面涂布 PI 胶后涂布光刻胶,再经过曝光、显影工艺加工光刻图形。因PI 胶加光刻胶在曝光后均需要显影使得被感光部分的 PI 胶和光刻胶溶解后被水冲走形成图形,而普通的显影工艺因不能正常溶解PI 而造成 PI 残留,远远不能达到工艺需求,因此PI 显影工艺在 PI 工艺开发中至关重要,其显影工艺关乎光刻图形的优劣。
实验
1. 实验材料
硅片若干、涂胶机台 PTT12-C、PI 胶 SP-341(聚酰亚胺)、光刻机台 PNS03、显影液 ZX-238(四甲基氢氧化铵)等。
2. 实验内容
2.1 PEB(Post Exposure Bake)工艺拉偏实验
在实验初期使用在线生产所用PEB 工艺,显影后 PI Space 区胶条形貌差,局部会出现锯齿情况,影响晶圆表观。通过对不同PEB 温度拉偏,发现PEB 温度对此异常影响较明显,因此对PEB 温度进行控制变量分析。
实验条件:
A、实验基底材料:硅片假片 。
B、涂胶轨道机 ID/ PI 材料:PTT12/SP-341。
C、曝光机台 ID/曝光条件:PNS03/WJ0143-PIQ。
实验结果见下表1:
表 1.PEB 拉偏实验结果

PEB 实验分别对显影前热板温度和显影前热板时间进行拉偏,温度设定分别为 115℃、120∘C 、 125∘C 、 130∘C ,热板时间分别为 60s、120s、180s、240s,其实验组合情况见表1,可组合为以上7 种条件。
根据以上7 种组合条件的结果可以看出:显影前热板温度在115℃时,热板时间的增加对于显影形貌无明显改善,因此固定显影前热板时间为60s,对显影前温度进行拉偏。从拉偏结果来看,PEB 温度在 120~125 度内,光刻图形形貌较好,无显影残留,图形打开区线条形貌好,PEB 温度提升或降低易引发Space 区胶残留和锯齿异常,显影时间增长会导致残胶,因此 PEB工艺通过实验后确定最佳温度及时间可设定为123 度60S。
2.2 显影工艺拉偏实验
在 PI 工艺开发阶段显影时发现,本司在线常规显影菜单其显影能力不足,打开区 PI 严重残留。针对 PI 显影开发新的显影菜单,由于 PI 显影时为光刻胶层和PI 层同时完成显影步骤,因此,需要的显影工艺作业时长需要加长,通过拉偏显影时长对显影后 PI 图形的影响实验,从中摸索出最佳双显影菜单时长,可以解决常规显影菜单引发的 PI 显影残留问题。
实验条件:
A、实验基底:硅片假片,片号详见下表2。
B、涂胶轨道机 ID/ PI 材料:PTT12/SP-341。
C、显影轨道机 ID/涂胶菜单/软烘条件: PTT12/ D36111/123 ℃60S。
D、曝光机台 ID/曝光条件:PNS03/WJ0143-PIQ。
实验结果:
表2.显影时间拉偏实验结果

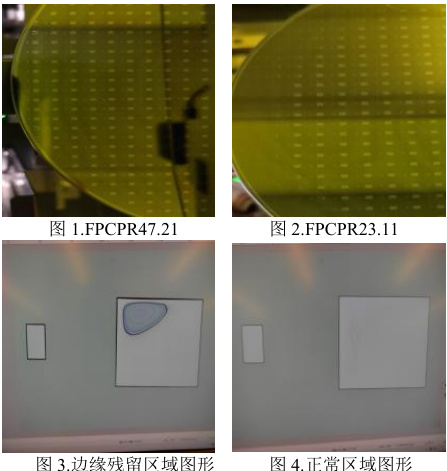
图 1 及图 2 分别为 FPCPR47.21 晶圆和 FPCPR23.11 晶圆的光检照片,图 3 及图 4 分别为FPCPR47.21 晶圆和 FPCPR23.11 晶圆的显微镜镜检照片,从图中可明显看到光检异常及镜检异常:圆片边缘出现了不同程度的残留,图形未被正常显开。此两片实验条件分别为缩短显影时间共计50s 及70s,同时从实验结果来看,显影时间减少 30s 时,PI 图形无残留,随着显影时间缩短,图形的显开情况更差。
当在显影总时长 111S 的基础上减少50S 后,圆片边缘最边缘一圈管芯开始出现显影残留,因此显影总时长至少需在 61S 以上才可保持图形正常。
同时在显影后,分别测试 FPCPR41.13、FPCPR41.11、FPCPR41.21 三片晶圆图形的 CD,测试方法为5 点测试法,分别测试圆片的中、上、右、下、左5 处位置的图形CD,其结果如下表 3 所示。
表 3. 显影后 CD 数据

从表 3 可见,显影时长每减少 20S,CD 减小约 5um,因此结合此前显影时间拉偏情况来看,显影工艺流程目前总时长 101s 为最佳时长。
结论
本文通过对 PI 工艺中的显影前PEB 时间温度、显影时间等因素进行拉偏实验,成功总结出 PI 显影工艺所需的 PEB 时间和温度为 123∘C 60s,以及显影总时间 101s。本实验解决了 PI作业过程中易出现的显影残留、锯齿、光检异常等一系列异常。此工艺符合产品开发要求,可为更严苛的特殊器件提供流片条件,同时拓宽工艺平台、拓展产品类型、提高产品附加值、节约产品流片周期、给企业带来经济效益的同时推动了相关产业发展,形成新产品价值链条的供应孵化。
参考文献
[1]朱振宇,汪倩,刘杰,等.面向柔性电子器件的聚酰亚胺薄膜的性能研究进展[J].广州化工,2023,51(02):25-30.
[2]卢小闯,余文涛,翁梦蔓,等.电子器件用低膨胀聚酰亚胺薄膜研究进展[J].绝缘材料,2021,54(11):11-22.
[3]赵宇霄.新型聚酰亚胺材料的制备及在光电领域中的应用[D].天津科技大学,2024.
[4]电子级 PI 薄膜在半导体方面及微电子工业的应用.深圳市坦白胶带有限公司.2019.01.09
[5] 薛志亮. 聚酰亚胺在晶闸管芯片台面保护上的应用分析[J]. 中国新技术新产品,2017,(02):39-40.
[6]A.M.Wilson,D.Laks,S.M.Davis, 等 . 半 导 体 用 聚 酰 亚 胺 薄 膜 的 表 征 [J]. 电 子 元 件 与 材料,1986,(06):40-43+30.
.jpg)
.jpg)
.jpg)
.jpg)
.jpg)
.jpg)