一种多边形元胞结构的晶圆曝光问题和解决方案

李娜 吴慧敏 安静 刘亚慧 王丹丹 史韩萌 张婉
西安卫光科技有限公司 陕西 西安 710000
引言
随着全球经济和现代社会的不断发展,电能消耗量急剧攀升。电力电子系统作为电能转换与输送的关键工具,在轨道交通、通讯技术、医疗机械以及新能源发电等多个领域均得到了广泛的应用[1],其中,功率半导体器件作为电子电力技术的核心组件,具备强大的控制与调节能力 , 在 能 耗 控 制 方 面 至 关 重 要 [2-3] 。 金 属 氧 化 物 半 导 体 场 效 应 晶 体 管(Metal-Oxide-Semiconductor Field-Effect Transistor,简称 MOSFET)器件属于功率器件中的一种[4],具有开关速度快、输入阻抗高、无二次击穿、安全工作范围宽、元胞尺寸小等优点.MOSFET一般由有源区和终端组成,其中有源区由许多元胞并联形成,以增大器件的导通电流,其在制备工艺和应用方面相对成熟。
一、技术问题


MOSFET 的导通电阻(Darin-Source On Resistance,简称 Rdson)为器件导通时电流流经源漏之间的总电阻,即 Rds(on) Rsource Rch RA RJ RD Rsub,其结构及组成如图1 所示。
晶圆制备完成后,进行电参数测试,结果显示,晶圆Rdson 偏大,部分甚至超过产品要求规范,导致晶圆低良报废,其他电参数正常,其典型失效MAP 如图 2 所示,呈现 Block 规律。

图 2 晶圆测试 MAP 图
为了排查晶圆Rdson 异常原因,对该晶圆进行扫描电子显微镜以及切片分析,切片结果如图3 所示。从晶圆截面结构中发现,源区孔的CD 仅为 3.1um,远小于产品设计值4um,意味着在晶圆孔层工艺加工过程中,源区孔未完全打开或刻蚀干净。即 Rsource 偏大导致 Rdson 整体偏大。
图 3 晶圆截面形貌图
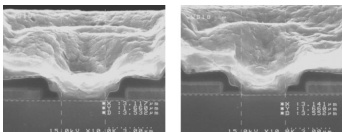
二、原因分析
分析导致这一结果的原因有二,一是在晶圆孔层刻蚀制程中,刻蚀能力不足,比如腐蚀液(气体)浓度配比异常、腐蚀温度以及时间不合理等;二是晶圆孔层光刻工艺过程中,曝光能量偏低导致光刻胶打开区的线宽较小,使得在后续刻蚀过程中对应的刻开区线宽较小,无法达到产品设计值。本文针对上述两个可能导致晶圆Rdson 失效的原因进行分析。
首先排除第一个原因,即晶圆孔层生产过程中刻蚀能力不足,这是因为异常批晶圆是量产晶圆中的其中一批,这批量产的晶圆共计 5 盒,每盒 10 片,这50 片晶圆属于同一种产品,设计结构以及生产工序均相同,这批晶圆孔层结构刻蚀生产过程中所用机台以及工艺流程完全一致,且异常批处于中间批次,其前后批晶圆 Rdson 均正常。另外,刻蚀作业过程中,机台状态良好,人为操作规范,未出现任何异常,通过分析,排除刻蚀工艺过程中的异常。
针对第二个原因,即晶圆孔层结构曝光过程中能力不足,导致光刻胶打开区线宽较小,进行重点分析。首先针对量产的 5 批晶圆孔层在光刻工序作业机台是否一致,作业过程中是否有异常进行排查,需要说明的是,晶圆在孔层的光刻生产工序,主要包括涂胶、曝光以及显影。通过排查发现,涂胶和显影制造过程,这 5 批量产的作业机台一致且机台无异常,人员操作规范无异常,但曝光过程中异常批曝光机台(又称光刻机A)和其他批次曝光机台(又称曝光机B)不一致。因此经过初步分析,该异常光刻机是造成此批晶圆报废的重要原因。
三、实验验证
为了进一步证实猜想以及解决此技术问题,进行实验验证。需要说明的是,因为上述异常片切片属于晶圆已经制造完成,即晶圆孔层结构后的金属层、钝化层等均已制备完成,为了更直观的对比异常光刻机与正常光刻机对孔层曝光所产生的影响,本次实验晶圆流片流片到孔层刻蚀完成后,进行切片分析。
具体的实验验证方案如下:设计对照组实验,对照组晶圆分别为晶圆a 和晶圆 b,其中,晶圆a 和晶圆b 其他生产制造条件均相同,仅曝光过程所选择的光刻机不同,晶圆a 在光刻机A 曝光,晶圆b 在光刻机B 曝光。需要说明的是,虽然选择的光刻机不同,但曝光条件相同,即曝光过程中的曝光能量、曝光时间等条件相同。晶圆孔层光刻工序完成后,进行光刻胶层的显微镜检测以及CD 测量,测量完成后,采用相同的刻蚀工艺条件进行孔层刻蚀,去除光刻胶后,对孔层进行显微镜检测和 CD 测量。测量完成后,两组实验晶圆片进行切片并利用扫描电子显微镜进行截面分析。
四、结果分析
表 1 是实验过程中晶圆 a 和晶圆 b 的线宽尺寸,由表1 可以看出,相同曝光条件下,型号相同的不同光刻机台,其光刻胶划片道上 CD bar 位置的线宽符合设计要求(设计理论值为2±0.2),因为目前产线在线检测采用的是量测 CD bar 的尺寸,若尺寸在规范内,认为产品该步骤合格,正因为如此,前述异常批才在该步骤未发现异常,继续流片。但从表中可以继续发现,晶圆 a 和晶圆 b 光刻胶元胞位置处的最小线宽差异较大,晶圆 a 上的光刻胶在元胞位置处的最小线宽平均值约 3.83,晶圆b 上的光刻胶在元胞位置处的最小线宽平均值约4.28,光刻胶元胞位置处的线宽差异,导致经过刻蚀后,晶圆 b 上的孔层元胞位置线宽参数符合产品设计要求,而晶圆 a 不符合。
表 1 晶圆 a 和晶圆 b 的线宽尺寸

为了进一步验证实验结果,对经过刻蚀后的晶圆 a 和晶圆b 进行切片以及扫描电子显微镜分析,图4 为晶圆a 孔层刻蚀后元胞位置截面图,图5 晶圆b 孔层刻蚀后元胞位置截面图。从图 4 可以看出相同曝光条件下,采用光刻机 A 曝光后,元胞孔层结构被刻蚀后的最小线宽约为3.4um,不满足产品技术要求,采用光刻机 B 曝光后,元胞孔层结构被刻蚀后的最小线宽约为4.1um,满足产品技术要求。通过扫描电镜数据分析,进一步验证了光刻机 A 在曝光过程中存在曝光能力不足,导致在晶圆元胞区,光刻胶打开区线宽较小,进而导致后续刻蚀过程中无法将孔层刻蚀刻蚀彻底,达到产品技术要求。
图 4 晶圆 a 孔层刻蚀后元胞位置截面图 图 5 晶圆 b 孔层刻蚀后元胞位置截面图
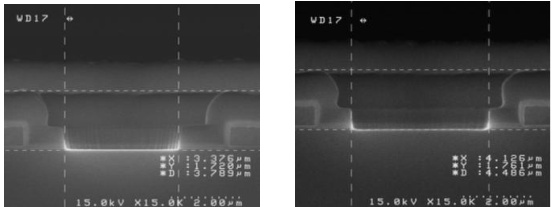
光刻机 A 和光刻机B 属于同一种类型,为 I 线光刻机,品牌相同,且实验过程中,各项指标参数均合格。为了进一步了解光刻机 A 作业该产品的异常,对该产品结构进行分析,从图 6可以看出,该产品元胞结构为六边形,曝光过程中,六边形结构的边缘突出位置对光线具有反射和折射的作用,容易影响聚焦,削弱了光线强度,因此,该产品结构的孔层对机台聚焦要求较高;另外对该光刻机 A 进行检测可知,该机台 Focus halving 部(包括电机与计数器)虽然检测结果正常,作业其他元胞结构的产品不存在任何问题,但鉴于该产品对聚焦要求的特殊性,为了避免上述技术问题的再次发生,采用如下解决方案,一是当作业此类多边形元胞结构的晶圆时,首先对该光刻机进行 Focus halving 部的数据检测,并收紧规范,二是在该机台作业此类产品时补偿一定的 Focus,确保在元胞光刻胶打开区曝光充足。
图6 晶圆六边形元胞孔底形貌(右侧放大图)
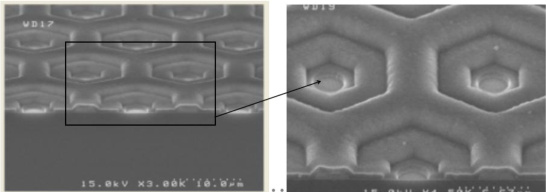
经产品验证,以上解决方案可行,有效解决了多边形元胞产品Rdson 失效问题,提升产品良率 30%~70% 。
五、结论
为了解决多边形元胞的晶圆导通电阻失效的问题,本文采用的技术方案是作业该产品前,首先对光刻机进行重点部位数据检测,并收紧规范值,另外,在机台补偿一定的Focus 值,以此确保晶圆元胞位置光刻胶曝光充分,不存在光刻胶残留,进而保证了后续刻蚀过程中的孔层底部刻蚀完全。
参考文献:
[1] 胡强, 王思亮, 张世勇. 从功率半导体器件发展看电力电子技术未来[J]. 东方电气评论,2015,29(03): 79-84。
[2] 马李卓. 硅基高压功率 VDMOSFET 器件设计[D]. : 电子科技大学, 2022。
[3] 刘国友, 王彦刚, 李想等. 大功率半导体技术现状及其进展[J]. 机车电传动, 2021, (05):1-11。
[4] 遇寒, 沈克强. 功率半导体器件的场限环研究[J]. 电子器件, 2007, (01): 210-214。
[5] 赵定远, 赵莉华. 现代电力电子器件的发展[J]. 成都大学学报(自然科学版), 2007, (03):210-214。
.jpg)
.jpg)
.jpg)
.jpg)
.jpg)