TRENCH MOS 平台光刻工艺菜单的开发

王丹丹 安静 李娜 邓佩荣 王雅惠
西安卫光科技有限公司 陕西西安 710000
引言
TRENCH MOS 工艺中,对良率影响较大的参数为光刻的 CD 以及膜厚[4],因此涂胶曝光和显影工艺菜单开发是光刻生产非常重要的工艺流程。工艺生产前,TRENCH MOS 平台涂胶机台、曝光机台、显影机台均需要进行验证作业前后颗粒变化;对涂胶工艺的膜厚厚度、膜厚均匀性、光刻胶截面形貌;曝光的 E0、TPR;显影的 E0等均有一定要求。
本文就 TRENCH MOS 平台涂胶曝光和显影工艺菜单开发所需验证的涂胶膜厚厚度、膜厚均匀性,曝光 E0、TPR,显影 E0 等匹配数据进行分析来说明通过 TRENCH MOS 平台涂胶曝光和显影工艺菜单开发,使得 CD 精度可以达到 0.7um 且图形显开区光刻胶形貌符合工艺规范。
实验内容:
分别测试涂胶、曝光、显影颗粒,调试机台颗粒值在验收规范内 (⩽30) ),调试涂胶膜厚为 10800±1 50 膜厚均匀性 Std:<55,曝光机台 TPR 在 0±0.2 规范内,以及曝光和显影机台的 E0 参数在 90±10 规范内,具体实验内容和工艺参数见表 1 所示。
表 1 工艺验收规范

一、 工艺菜单:
1) 工艺验证圆片准备:准备颗粒数少于 30 个/片的硅片 8 片,见表 2。
表 2 工艺验证圆片准备

2) 工艺菜单内容:
A.涂胶 15#流程如下图 1:此菜单为在硅片上涂胶,硅片首先涂布 HMDS(六甲基二硅胺)作为增粘剂,随后于其上喷洒 EBR 进行预润湿,接着进行光刻胶的涂布,涂布后进行匀胶、热板烘烤,经过此过程硅片涂胶便已完成,此菜单命名 E08,编号为 15。
B. 在涂完光刻胶的硅片上进行曝光,曝光菜单 WJ0230A.TRE 其曝光 MAP 如下图 2。
曝光、显影机台进行工艺过程的传输,工艺结束后再使用颗粒测试仪对分别进入不同机台的颗粒片进行测试,测试结果为后值,颗粒总数=后值-前值,测试结果见表 1:
表 1.机台颗粒数

结论:验证规范为颗粒总数﹤30 个,从上表 1 的测试数据可以看出,涂胶、曝光、显影机台的颗粒数均符合验收标准。
二、 E0&TPR 测试:
A)曝光 E0 测试:
ⅰ).验证过程:用菜单 15#在 2 片裸硅片涂胶后,在曝光机台 PNS03 用 E0.E0 菜单进行曝光,随后进行显影(为避免误差,使用 2 片同时作业,确保参数可信)。完成后在显微镜进行(After Devolpe Inspection)读值,其数据计算公式为:E0=初始值+显示方块个数*步进数值。曝光机台 E0 读值数据见表 2
表 2.曝光机台 E0

结论:由表 2 可看出,曝光机台 E0 在规范内,符合 90±10 的工艺要求。
ⅰ).验证过程:用菜单 15#在 2 片裸硅片涂胶后,在曝光机台用 E0.E0 菜单进行曝光,随后于 PTT03-D 进行显影。完成后在显微镜进行读值。读值数据见表 3。
B) 显影 E0 测试:
表 3.显影机台 E0

结论:由表 3 可看出,显影机台 E0 在规范内,符合 90±10 的工艺要求。
C) 曝光 TPR 测试:
ⅰ).验证过程:用 recipe 15#在 2 片裸硅片涂胶后,在曝光机台 PNS03 用 TPR 菜单进行曝光,随后在 PTT03-D机台进行显影。完成后在显微镜进行 ADI 读值。读值数据见表 4。
表 4.曝光机台 TPR

图 2.曝光 MAP
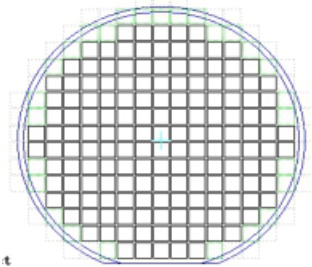
结论:由表 4 可看出,曝光机台 TPR 在规范内,符合 0±0.2 的工艺要求。
三、 单项测试数据
A) 光刻胶测试点图案:光刻胶膜厚测试的 MAP 图见图 4.1,为 9 点测试法;CD 测试点图案:CD 测试的MAP 见图 4.2,为 5 点测试法。
结果和讨论
C.曝光后的硅片进行显影,此显影菜单命名为 0221A,编号为 20,显影具体步骤:热板软烘、冷板降温、显影、热板烘烤后退片。
ⅰ).验证过程:先取六片颗粒片在颗粒测试仪上测得每片硅片的颗粒数据为前值并记录,然后分别拿到涂胶、
一、 颗粒测试:
图 1.1 光刻胶测试点图案
图 1.2CD 测试点图案

B) 圆片光刻胶膜厚测试:
ⅰ).验证过程:在涂胶机台 PTT03-C 上使用 Recipe 15#在 2 片裸硅片上进行涂胶,在卡塞中放入裸硅片,待工艺完毕后,每片测试九点,测试数据见表 5。

ⅱ).光刻胶膜厚图见图 2。
图 2.光刻胶膜厚测试图表

表 5.涂胶膜厚及均匀性

由图 2 可知,膜厚测试 9 点均在规范膜厚内,且其均匀性复合工艺规范,测试结果均满足规范要求:(THK:10800  150 std:<55)
150 std:<55)
四、 CD 测试数据:
ⅰ).验证过程:按顺序在硅片上进行涂胶、曝光、显影处理:在卡塞中放入裸硅片,待工艺完毕后,每片测试五点见图 1.2,测试数据见表 6
表 6. TRENCH MOS 产品 CD 数据

ⅱ).CD 测试数据:在 CDSEM 机台测试 TRENCH MOS 产品的 CD,5 点数据(从左到右依次为产品片的中、上、右、下、左 5 个位置)
结论:从图 6 可知,圆片 01#和 02#的 CD 均为 0.72 左右,在规范 (ϵ0.7±0.07μm) )内,满足工艺需求。结论
从上述实验验证数据结果来看,TRENCH MOS 平台涂胶曝光和显影工艺菜单开发工艺结果能满足生产需求,产品 CD 可达到 0.7μm 且光刻胶角度 ⩾83∘ 。
参考文献
[1]包慧萍.低压 Trench MOSFET 的辐射效应研究[D].电子科技大学,2018.
[2]李东民.功率槽型 MOSFET 开关特性研究[D].西南交通大学,2019.DOI:10.27414/d.cnki.gxnju.2019.000145.
[3] 王 卓 , 李 鹏 程 , 张 波 , 等 .Ultralow Specific on-Resistance Trench MOSFET with a U-Shaped ExtendedGate[J].Chinese Physics Letters,2015,32(06):192-195.
[4]单忠飞.消除 TrenchMOS 表面静电的光刻工艺改进[D].上海交通大学,2010.
.jpg)
.jpg)
.jpg)
.jpg)
.jpg)
.jpg)